
▲ 이강욱 SK하이닉스 패키지개발담당 부사장이 11일 서울 강남구 코엑스에서 열린 '세미콘코리아 2026'의 인공지능(AI) 서밋에서 발표하고 있다. <연합뉴스>
이강욱 SK하이닉스 패키지개발담당 부사장은 11일 서울 강남구 코엑스에서 열린 '세미콘코리아 2026'의 인공지능(AI) 서밋에서 "HBM4E(7세대)·HBM5(8세대) 등 차세대 제품으로 가면서 고객이 자신에 맞는 시스템인패키지(SiP)를 요구하는 형태가 증가하고 있다"고 말했다.
그는 "이에 대응해 향후에는 'HBM B·T·S' 라는 콘셉트가 필요할 것"이라고 강조했다.
HBM B·T·S는 B(Bandwidth, 밴드위스), T(Thermal Dissipation, 열 방출), S(Space Efficiency, 면적 효율)에 특화된 HBM을 말한다.
이 부사장은 "고객들은 각 영역에서 굉장히 특화된 HBM을 요구하고 있다"며 "어드밴스드 패키징 기술을 통해 여러 플랫폼을 준비하고 고객의 요구에 능동적으로 대응해 나가고자 한다"고 말했다.
SK하이닉스는 20단 이상의 HBM 제품 개발부터 하이브리드 본딩 기술을 도입한다.
이 부사장은 "SK하이닉스는 독자 패키징 기술인 '매스리플로우-몰디드언더필(MR-MUF)'를 활용해 16단까지 적층할 수 있는 기술을 개발했다"며 "그러나 20단 이상을 위해서는 어느 시점에서 하이브리드 본딩 기술이 굉장히 필요할 것"이라고 내다봤다. 나병현 기자
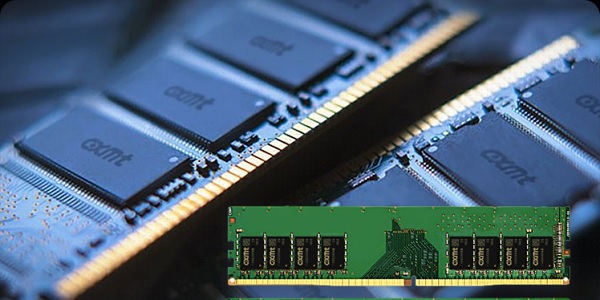
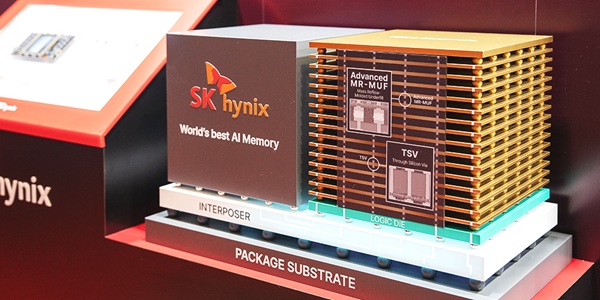




![[한국갤럽] 이재명 지지율 61%로 3%p 내려, 민주당 45% vs 국힘 23%](https://businesspost.co.kr/news/photo/202605/20260515114313_87595.jpg)



